解讀:IC封裝行業的最新技術和市場趨勢
芯粒為3D IC封裝錦上添花
還有一種使用芯粒(chiplet)的3D IC封裝,是由AMD發明的,臺積電、英特爾、華為海思都在研究。它可以實現CMOS器件與非CMOS器件的異構集成,或許有助于讓摩爾定律繼續下去。這個想法是將一個大的SoC分解成更小的芯粒,以提高良率和降低成本,同時提高客戶的可重用性。芯粒模式允許設計人員像搭積木一樣制造芯片,利用各種IP而不考慮它們是在哪個節點或用什么技術制造的;它們可以構建在各種材料上,包括硅、玻璃和層壓板。
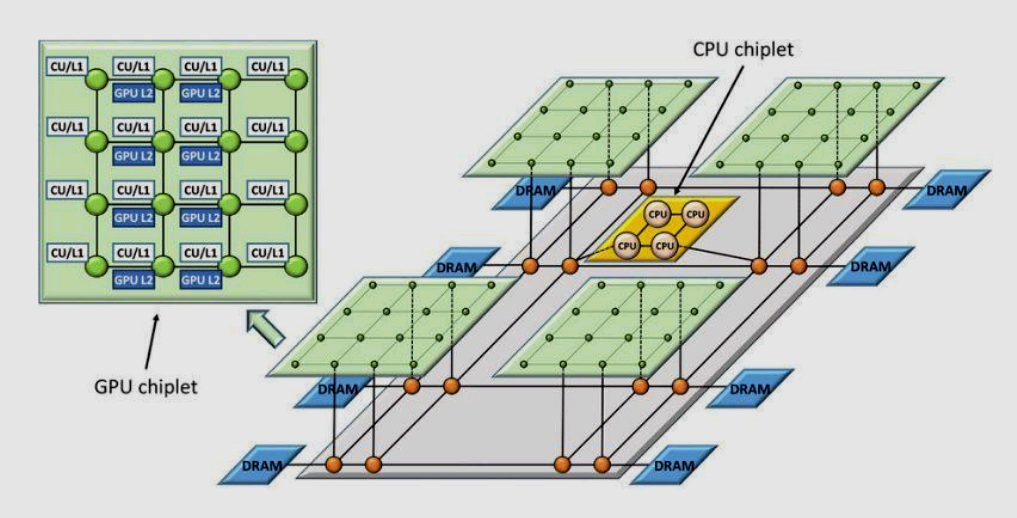
芯粒有望延續摩爾定律
下一代IC設計人才必須懂封裝
美國喬治亞理工學院(Georgia Tech)教授、超大規模集成電路(VLSI)數字暨混合信號設計專家Arijit Raychowdhury表示,先進IC設計的新疆域在于封裝。
他說:“封裝是一個設計工程師必須了解的。”先進IC設計的重點已經從工藝技術轉向封裝技術,但問題在于“業界對于這種轉移將如何進展的了解不夠。”他認為臺積電是一家在這方面表現得比較好的公司。
他指出:“芯片產業已經意識到,依循摩爾定律的工藝微縮速度已經趨緩,而產業界似乎不愿意面對芯片設計即將發生的巨變──從工藝到封裝技術的轉變。”
現在,晶體管微縮已經接近極限,但從技術上來看,也許微縮演進的速度不如我們想的那么快。以內存制造技術或后道工藝晶體管技術為例,他認為還會有很多新的東西出現,產業界應該在這個特定領域快速行動起來,去探討這方面的“黑魔法”。
面對封裝的技術演進和挑戰,你準備好了嗎?
請輸入評論內容...
請輸入評論/評論長度6~500個字
最新活動更多
-
11月20日立即報名>> 【免費下載】RISC-V芯片發展現狀與測試挑戰-白皮書
-
11月20日立即報名>> 芯智所向 邊緣無界—華邦電子與恩智浦聯合技術論壇
-
即日-11.25立即下載>>> 費斯托白皮書《柔性:汽車生產未來的關鍵》
-
11月27日立即報名>> 【工程師系列】汽車電子技術在線大會
-
11月28日立即下載>> 【白皮書】精準洞察 無線掌控——283FC智能自檢萬用表
-
即日-12.12點擊報名>>> 【免費試用】宏集運輸沖擊記錄儀








 分享
分享












